文 | 半导体产业纵横,作者 | 鹏程
在半导体产业深度变革的关键阶段,摩尔定律传统驱动力逐渐减弱,先进制程节点成本持续走高,单一芯片性能提升难以仅依靠晶体管尺寸缩小实现突破。而人工智能 (AI)、高性能计算 (HPC)、5G 通信、云数据中心及消费电子等领域,对计算能力、功耗效率和集成度的需求不断升级,在此背景下,先进封装技术成为突破性能瓶颈、推动行业持续增长的核心路径。其中中介层技术的发展与革新更是关键所在。
什么是先进封装的中介层
在人工智能时代,先进封装从芯片制造流程中“ 后续需考虑的环节” 跃升为提升功耗、性能、面积及成本效率的核心要素。再布线层 (RDL) 作为实现这些提升的重要手段,虽未在所有人工智能封装中应用,但在扇出型晶圆级封装 (FoWLP)、CoWoS 设计以及嵌入式晶圆级球栅阵列 (eWLB) 中均有广泛应用。
RDL 主要通过两种方式集成到封装中。一种是依托硅等载体,在硅载体方案里,RDL 可根据应用需求置于硅的顶部或底部,硅起到承载 RDL 的作用;另一种则完全舍弃载体,直接单独使用 RDL。通常,这些载体 (若无载体则指 RDL 本身) 被称为“ 中介层 (interposer)”。
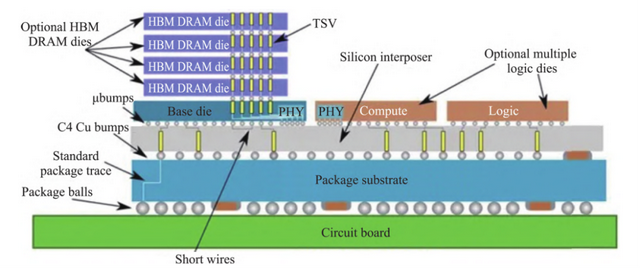
一种典型异构集成 2.5D 封装结构
当前主流的 2.5D 封装结构中,多种技术方案均围绕中介层展开:
CoWoS 技术作为最典型的 2.5D 封装结构,由台积电率先提出。该技术先通过 CoW 封装工艺将芯片连接至硅晶圆,再将 CoW 芯片与基板连接,最终整合为 CoWoS。经过发展,CoWoS 技术已衍生出多种形式,包括以硅为中介层的 CoWoS-S、以 RDL 为中介层的 CoWoS-R,以及由芯粒和 RDL 构成硅桥作为中介层的 CoWoS-L。
EMIB(嵌入式多芯片互连桥) 技术是由英特尔 (Intel) 提出的另一种 2.5D 封装技术。与其他技术不同,EMIB 不采用常见的大型硅中介层,而是运用具有多个布线层的小型桥接芯片实现芯片间的连接。
I-Cube 技术是三星半导体推出的 2.5D 封装技术,通过在中介层上水平放置多个逻辑裸片 (如 CPU、GPU) 和 HBM 裸片,实现异构集成,让多个裸片在一个封装内如同单个芯片般协同工作。根据中介层的不同,可分 I-CubeS 和 I-CubeE 两种,分别对标台积电的 CoWoS-S 和 CoWoS-L。I-CubeSc 采用硅中介层。I-CubeE 无 TSV 结构,采用嵌入式硅桥。

在工艺层面,中介层通常以硅片为载体 (也有对玻璃、陶瓷等材料的尝试),在载体上加工精细的布线和通孔 (TSV,硅通孔),从而实现不同芯片间高带宽、低延迟的连接。简单来说,中介层就像一块超高密度的电路转接板,将多颗芯片“ 拼接” 在一起,再统一与外部的封装基板连接。
相较于无中介层的传统封装,加入中介层具有重要意义:一方面,大幅缩短多芯片间的信号走线,显著降低功耗与延迟,同时提升带宽;另一方面,能够灵活组合不同工艺、不同功能的芯片,例如逻辑芯片与存储芯片无需在同一工艺厂制造,也不必制成单片 SoC,就能在封装层面实现“ 异构集成”。
中介层有了新选择
在 AI 芯片中,RDL 的核心作用是实现 HBM 堆叠与 xPU 之间的通信,并通过缩小线宽/线距提高互连密度。基于这一目标,不同的 RDL 应用方式及各类中介层技术通过差异化路径实现功能。目前 2.5D 封装中介层结构主要包括再布线层 (RDL)、嵌入式互连桥、硅中介层、玻璃中介层、陶瓷中介层等,其中硅中介层是当前主流方案,但各类新型中介层技术正不断崛起。
主流硅中介层:成熟与局限并存
台积电最早提出硅中介层方案,并借助 CoWoS 工艺实现量产,2012 年为赛灵思生产的 Virtex-7 FPGA 成为该技术首个大规模应用案例。硅中介层的核心优势在于工艺成熟,可实现亚 10μm 的超细布线与多层 TSV 结构,能完美适配高性能计算 (HPC) 对高密度互连的需求,目前已在生产中大量应用。
然而,硅中介层的短板也十分突出:其一,成本高昂,“ 圆切方” 的几何损耗随面积增大而急剧上升,良率控制难度较大;其二,存在散热瓶颈,当 AI 芯片功率突破千瓦级时,硅约 150-160 W/m・k 的热导率难以满足散热需求;其三,在高频条件下,信号串扰和插损问题显著,导致可靠性下降,较高的价格也限制了其应用范围。
为破解硅中介层的成本困境,有机中介层 (亦称 RDL 再布线层) 在 2010 年代中期随 Fan-Out 封装兴起。该技术采用面板级生产 (PLP) 模式,大幅提高了产能利用率,材料与设备成本显著降低,且布线层数可灵活定制,成为大规模 AI 训练芯片的经济之选。但受限于有机材料特性,其布线精细度不足 (线宽/线距较大),难以支撑对性能有极致要求的场景。
有机中介层:成本优势下的性能妥协

玻璃中介层具备独特优势,能够支持嵌入基板的芯粒与直接堆叠于顶部的芯粒 (chiplets) 之间的 3D 堆叠,这是硅中介层无法实现的功能。实验数据显示,与硅中介层相比,玻璃中介层可实现 2.6 倍的面积优化、21 倍的线长缩短,全芯片功耗降低 17.72%,信号完整性提升 64.7%,电源完整性改善 10 倍,不过其在工作过程中温度会升高 15%。
玻璃中介层:突破 3D 堆叠与性能优化
玻璃中介层具备独特优势,能够支持嵌入基板的芯粒与直接堆叠于顶部的芯粒 (chiplets) 之间的 3D 堆叠,这是硅中介层无法实现的功能。实验数据显示,与硅中介层相比,玻璃中介层可实现 2.6 倍的面积优化、21 倍的线长缩短,全芯片功耗降低 17.72%,信号完整性提升 64.7%,电源完整性改善 10 倍,不过其在工作过程中温度会升高 15%。
此外,玻璃中介层还存在创新应用方向,如实现玻璃中介层和封装载板二合一,让 Die 直接上基板形成极简结构。更有甚者,AI 设计公司与先进封装厂在对玻璃中介层与玻璃基板的封测成品论证后,发现有机 PCB 的热膨胀系数 (CTE) 与玻璃复合体不匹配,计划尝试用玻璃 PCB 替代有机 PCB,或整合相关结构在其上堆叠各类小芯片。
陶瓷中介层:性能优异但量产受限
陶瓷中介层采用 AlN 和 Al₂O₃等陶瓷材料,拥有优良的绝缘性和机械性能,其中 AlN 陶瓷还具备低热膨胀系数、高电阻和高导热性等优势。但陶瓷材料加工需采用静压粉末压制工艺,不仅成本高昂,加工效率也很低,难以实现大规模生产,限制了其在产业中的广泛应用。
碳化硅 (SiC) 中介层:AI 高功耗场景下的新突破
2025 年以来,碳化硅 (SiC) 中介层凭借颠覆性优势成为行业焦点,其发展的核心驱动力源于 AI 芯片功率的急剧飙升。英伟达计划推出的 Rubin Ultra 处理器功率将达 3600W,传统硅中介层已触及散热极限,而 SiC 中介层的材料特性恰好能满足高功耗场景需求。
当前 AI 芯片功耗随算力提升持续突破上限,英伟达 H100 GPU 功耗已达 700W,下一代 Rubin 处理器预计突破 1000W,传统硅中介层的性能瓶颈愈发凸显—— 热导率仅 150W/mK,热膨胀系数 (4.2ppm/℃) 与芯片材料适配性不足,导致散热效率低下,直接造成芯片性能降频、可靠性下降。
SiC 中介层的优势十分显著:热导率达 490W/mK(是硅的 3 倍以上),热膨胀系数 (4.3ppm/℃) 与芯片材料高度契合,既能高效散热,又能保障封装稳定性。实测数据显示,采用 SiC 中介层后,H100 芯片工作温度可从 95℃降至 75℃,散热成本降低 30%,芯片寿命延长 2 倍;同时,SiC 支持高深宽比通孔设计,可使互连距离缩短 50%,数据传输速度提升 20%,相当于为 AI 芯片搭建了“ 高速数据通道”。
SiC 中介层的技术突破主要体现在三个方面:一是热导率达 490W/m・k,为硅的 2-3 倍,可大幅缩小散热片尺寸,优化封装体积;二是单晶 SiC 耐化学性强,可通过湿法刻蚀制备深宽比 109:1 的非直线通孔,远超传统硅中介层 17:1 的上限,实现更短互连长度与更高集成度。不过就目前情况而言,使用桥接芯片和硅中介层在技术复杂度和成本控制上仍可能是更简单的解决方案。
不过就目前情况而言,使用桥接芯片和硅中介层仍可能是更简单的解决方案。
全球大厂的新中介层材料布局
面对中介层材料的技术变革,全球半导体巨头纷纷展开全方位布局,形成“ 技术研发+生态共建+产能储备” 的竞争态势,旨在抢占先进封装中介层技术的制高点。
在玻璃中介层领域,三星电子已明确计划,将于 2028 年将玻璃基板引入先进半导体封装领域,核心举措是用“ 玻璃中介层” 取代“ 硅中介层”,这也是三星电子玻璃基板路线图首次被公开确认。据知情人士透露:“ 三星电子已制定详细计划,2028 年将硅中介层转换为玻璃中介层,以更好地满足客户需求。”
三星电子正与供应链企业展开商谈,计划在根据芯片尺寸定制的“ 单元” 中应用玻璃中介层,而非传统的玻璃基板。通常,玻璃基板原始尺寸为 510×515mm,需切割成适合芯片的尺寸,英特尔、Absolix 等公司正以这种方式生产原型产品。与之不同的是,三星电子选择在 100×100mm 以下的玻璃上开展相关工艺。业内人士分析,这一策略主要是为了加快技术实施和样机生产速度,从而快速进入市场,但从实际量产角度来看,较小的尺寸可能会导致生产率降低。
此外,三星电子还制定了配套计划,将外包公司提供的玻璃中介层与天安园区生产的半导体进行封装整合,并计划利用已建成的面板级封装 (PLP) 生产线。PLP 是一种替代在圆形晶圆上进行封装的晶圆级封装 (WLP) 技术,通过在方形面板上进行封装,具有生产率高、适合玻璃基板工艺的优势,为玻璃中介层的规模化应用提供了工艺支撑。
作为 CoWoS 封装技术的主导者,台积电采取双轨并行的策略布局中介层技术。一方面,通过持续的技术升级延续硅中介层的优势,2025 年已实现 3.5 倍光罩尺寸的 CoWoS-L 封装量产,未来还将推出 7 倍光罩尺寸的方案,有效缓解大尺寸中介层的成本压力,进一步巩固在硅中介层应用领域的领先地位。
另一方面,台积电积极牵头碳化硅 (SiC) 中介层的研发工作,已邀请全球多家厂商组建技术联盟,并联合日本 DISCO 公司开发适配 SiC 的激光切割设备,明确目标在 2027 年前实现 SiC 中介层的量产落地,为应对 AI 芯片高功耗需求做好技术与产能储备。
英伟达也是碳化硅 (SiC) 中介层技术的核心推动者,其新一代 Rubin 处理器已明确将硅中介层替换为 SiC,并计划在 2027 年前完成技术导入。这一举措不仅是为了解决自身 AI 芯片的散热瓶颈,更将对整个半导体供应链格局产生深远影响。
据摩根士丹利预测,2026 年全球 CoWoS 封装月产能将达到 11.2 万片,若 SiC 中介层渗透率逐步提升,12 英寸 SiC 晶圆的年需求量或将达到 26 万片,这将催生全新的市场空间,带动 SiC 材料、加工设备等相关产业链环节的发展。
日本半导体材料制造商 Resonac 宣布成立由 27 家全球企业组成的联盟“JOINT3”,核心目标是共同开发先进的芯片封装技术。该联盟成员涵盖美国、日本、新加坡等多个国家的材料制造商、设备供应商与芯片设计公司,如应用材料、东京威力科创等行业知名企业。
Resonac 在声明中表示,联盟将整合各方资源,共同开发用于制作以有机材料方形基板打造的中介层 (interposers) 所需的材料、设备与设计工具,并计划利用 515×510mm 的基板作为评估试作产线,推动有机材料中介层技术的研发与产业化进程,为中介层技术发展提供更多创新选择。
更多精彩内容,关注钛媒体微信号 (ID:taimeiti),或者下载钛媒体 App




























